
银价高不用愁!康普锡威推出低成本高性能无铅焊料,性能媲美高银合金。
近年来,贵金属银价格持续高位运行,给电子制造企业的成本控制带来巨大压力。传统SAC305(含银3.0%)等无铅焊料虽具备优良的综合性能,但其较高的银含量导致材料成本居高不下,给企业带来较大成本压力。若降低银含量,则难以保证焊料性能;若继续使用高银合金,则企业生产成本难以控制。
这个两难困境,终于有了完美解决方案!
康普锡威依托在无铅焊料领域多年的技术积淀,重磅推出LF522系列低银无铅焊料,银含量仅1.0%,却实现了媲美甚至超越SAC305的综合性能,可为SMT时代电子封装提供可靠、环保且极具成本优势的焊接材料解决方案。
1
降本不降性,LF522系列焊料凭实力说话
1.1 银含量降低67%,性能平替SAC305
性能指标 | LF522系列 | SAC305 | 对比优势 |
银含量 | 1.0% | 3.0% | 成本大幅降低 |
熔点(℃) | 214-222 | 217-220 | 相差不大 |
抗拉强度 (MPa) | 73 | 35.5 | 大幅提升 |
延伸率(%) | 20 | 34.5 | 相对下降 |
铺展面积 (mm²) | 43 | 38 | 润湿性出色 |
比热容 (J/(g*k)) | 0.243 | 0.232 | 相差不大 |
密度 (g/cm3) | 7.38 | 7.37 | 相差不大 |
线膨胀系数 (30℃,(10-6/℃)) | 23.6 | 23.5 | 相差不大 |
1.2 微观结构决定宏观性能
LF522合金基体中,金属间化合物呈现理想分布:
? Cu-Sn化合物呈球形分布,细小均匀
? Ag-Sn化合物呈网状分布,强化基体
这种独特的微观组织大幅提高了合金的屈服强度和抗拉强度,让低银焊料也能拥有“钢筋铁骨”。

图1 LF522合金微观组织与金属间化合物
1.3 界面IMC更薄更强
LF522的界面金属间化合物层未形成明显的扇贝状突起,而是由细小的尖状或锯齿状晶粒紧密排列成较薄的IMC层。这种结构既可有效传递载荷,又不会成为裂纹源,实现高抗拉强度+优良塑性的双重优势。
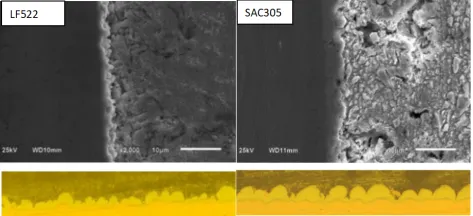
图2 焊接界面IMC形貌
1.4 可靠性全方位验证,不输高银合金
✅ 经过700h,125℃时效后,LF522合金界面稳定性比SAC305提高40%。
✅ 高低温循环性能,1000次循环后,LF522和SAC305,均未出现开裂。
✅ 剪切强度实测,不同元件/芯片LF522在多数测试点剪切强度与SAC305持平,焊点可靠性有保障。
2
更多“利器”等你来发现
除了LF522系列,康普锡威还有这些“杀手锏”:更低银含量的LF539无铅焊料、更高可靠性的LF516无铅焊料!
2.1低温焊料系列
包括SnBi58、LF143及SnBi基复合焊料,满足不同工艺需求。
2.2高导热复合焊料(重磅新品!)
针对AI大算力芯片、IGBT等高功率器件的严苛散热需求,康普锡威推出高导热复合热界面材料(TIM):
✨ 核心亮点:
一是利用高导热金属粒子构建高效热传导路径;
二是大幅提升高功率器件散热能力和信号传输能力;
三是添加高导热贱金属组份,显著降低材料成本;
四是适用于SnBi基及In基材料等多种合金体系。
? 展会预告
想亲身体验LF522、LF539的卓越性能?想知道高导热复合焊料如何破解散热难题?想了解高品质精细焊粉如何推动后SMT时代及先进封装的进程?
康普锡威将携全系列创新产品亮相本届行业展会,诚挚邀请新老客户莅临指导、洽谈交流!咱们现场不见不散?

? 展会地点: 慕尼黑上海电子生产设备展·上海新国际博览中心
? 展位号: E3馆 3712
? 展会时间: 3月25日—27日
ℹ️ 关于康普锡威
COMPO(康普锡威)长期专注于电子焊接材料的研发与创新,在无铅焊料领域积淀了深厚的技术实力与丰富的应用经验。
我们始终致力于为客户提供性能卓越、成本可控、绿色环保的焊接材料解决方案,以技术赋能产业,助力电子制造业高质量发展。
高银价时代,选对焊料,降本增效!康普锡威LF522焊料,让您不再为银价买单!

